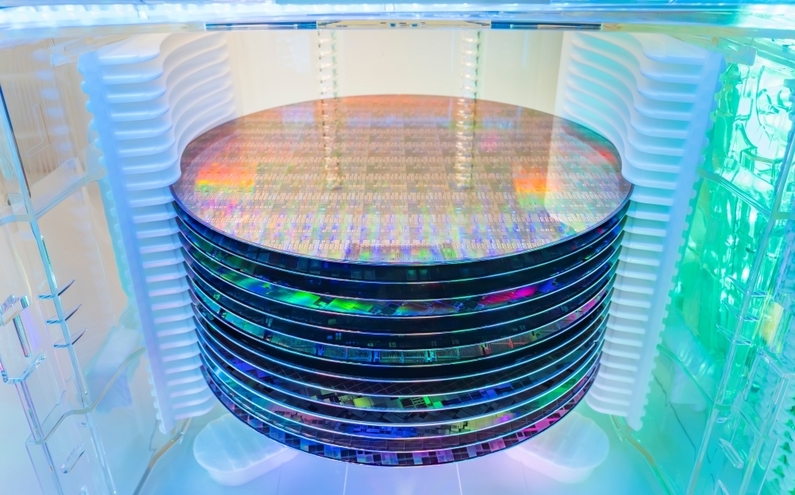
PI 사용하지 않음으로써 공정 단순화, 생산성 개선, 제품 신뢰도 향상돼
네패스라웨가 600mm FOPLP(Fan-out Panel Level Package)에 이어 첨단 패키지 기술 혁신을 이어가고 있다.
네패스라웨는 팬아웃 공정의 필수 재료인 고가의 폴리이미드(PI)를 사용하지 않고 몰딩 공법만으로 FOPLP를 구현했다고 밝혔다. 데카테크놀로지의 M-SeriesTM를 기반한 이 기술은 네패스라웨가 세계 최초로 상용화했으며, 미국 아날로그 및 차량용 반도체 전문 기업에 제품 공급을 개시한다.
해당 기술은 PI를 쓰지 않아 공정이 단순화하고 생산성이 좋아질 뿐 아니라 제품 신뢰성도 향상시킬 수 있어 QFN과 같은 기존 컨벤셔널 몰딩 패키지의 영역을 광범위하게 대체할 것으로 기대된다. 특히 다양한 제품을 수시로 변경하고 개발해야하는 아날로그 반도체 제조사들은 PCB 및 리드 프레임 등의 재료 수급 리스크를 줄인다.
기존 반도체 규격을 유지하며 팬아웃 공정으로 전환이 가능해 고객의 신규 인증 부담을 낮추는 것 역시 강점이다. 특히, 차량용 마이크로컨트롤러유닛 (MCU)와 같이 생산량이 많고 전방 고객 인증이 까다로운 제품에 적용 시 제조 및 품질 관리의 이점을 제공할 것으로 기대한다.
네패스 관계자는 “팬아웃 몰딩 기술 상용화로 첨단 패키지 시장에서 기술 경쟁력을 한층 강화하게 될 것으로 보인다”고 전했다. 네패스라웨는 금번 아날로그 반도체 샘플 공급을 시작으로 모바일 이외에 산업용, 자동차 등 다양한 응용제품에 팬아웃 PLP 기술을 적용해 고객을 확장한다는 전략이다.
헬로티 서재창 기자 |


















































