모바일 기기용 실장기술의 현황과 전망
스마트폰으로 대표되는 모바일 인터넷 기기가 급속도로 보급되면서 고성능화·고기능화·소형화·박형화에 대한
요구가 한층 증가하고 있다. 특히 최근 들어 이들 기기에서 다양한 애플리케이션 동작과 고속 데이터 통신이
실현되면서, 기기를 구성하는 전자회로에서 데이터를 처리하는 프로세서·화면을 표시하는
디스플레이·무선통신을 처리하는 RF회로에서는 고성능화와 저전력화의 양립이 중요시되고 있다.
이에 따라 여기서는 이를 실현하는 실용화가 진행 중인 실장기술과 관련 장치·시스템·접합재료 등을 자세히
살펴본다
서론
디지털 네트워크 정보사회로 발전하면서 스마트폰으로 대표되는 이동통신 시장에서는 컴퓨터 수준의 애플리케이션 사용이 가능해졌다. 이를 통해 고성능 프로세서를 탑재한 스마트폰이나 태블릿 단말로 불리는 모바일 인터넷 기기의 보급이 급속히 진행됨에 따라, 이들 기기에서는 고성능화(데이터 처리의 고속화/메모리 용량 증가), 고기능화(복합화/융합), 소형·박형화에 대한 요구가 한층 증가하고 있다.
또한 최근 이들 기기에서는 다양한 애플리케이션 동작과 고속 데이터 통신이 실현되면서 배터리 구동시간을 얼마나 늘릴 수 있는지가 중요한 과제로 부각되고 있는데, 이로 인해 기기를 구성하는 전자회로에서 데이터를 처리하는 프로세서·화면을 표시하는 디스플레이·무선통신을 처리하는 RF회로에서는 고성능화와 저전력화의 양립이 중요시되고 있다.
더불어 이러한 전자회로를 뒷받침하는 주요 기술로는 회로 형성 기술이 점차 중요해지고 있어, 이들 분야에서는 고밀도 실장이나 3차원 실장에 대한 요구가 지금보다 훨씬 증가하고 있다. 이에 따라 이 글에서는 현재 실용화가 진행되고 있는 실장기술과 이와 관련된 장치·시스템·접합재료 등을 자세히 살펴본다.
전자기기 동향으로 살펴본
구성 부품과 실장기술의 변화
현재 급속도로 보급되고 있는 스마트폰은 컴퓨터 기능을 탑재한 다기능 휴대전화로, 전화·이메일·게임·TV·내비게이션 등을 포함한 인터넷을 통한 통신이 다양화되고 있어 향후 이들 기기에서 대용량의 고속 데이터 통신의 보급은 기존보다 더욱 활성화될 것으로 예상되고 있다.
그동안 이들 기기에서는 그림 1에서 보여주는 것처럼 다양한 디바이스나 기능 부품의 고밀도 실장을 통해 다양한 기능들이 실현돼 왔다.

그러나 최근 기기 내부에서 배터리 공간의 확보가 무엇보다 우선시되면서 프린트 배선판에서 부득이하게 초소형화·다층 박막화가 요구됨에 따라, 기판 양면에서 자연스럽게 고밀도 실장을 구현하는 방법이 강구되고 있다. 또한 프린트 배선판의 저비용화(양산용 패턴/저비용 재료)에 따른 폐해 중 하나로 꼽히는 랜드의 위치 정밀도 편차를 허용하여 고품질 실장을 실현하는 기술도 요구되고 있다.
이 중 특히 카메라 모듈·마이크·진동 모터 등에 대해서는 메인 기판에서 서브 기판으로 이동하여 향후 제시될 복잡한 형상의 플렉시블 기판(양산용 패턴/분할시트 단일패턴)과 리지드 플렉시블 기판에 의한 다양한 기판 형태에 대응하는 기술이 요구되고 있다.
이를 위해 LSI 패키지의 협피치화(0.65mm⇒0.4mm⇒0.3mm 피치)와 소형화가 진행되고 있는 동시에, 칩 부품의 경우에는 현재 주류로 사용되고 있는 0603 부품뿐만 아니라 지금까지 주로 모듈 부품용으로 사용돼오던 0402 부품이 메인 기판에 실장되고 있지만 향후 탑재비율의 확대나 부품의 소형화는 한층 가속화될 것으로 예상되고 있다.
또한 무선통신 처리를 담당하는 RF 모듈의 경우에는 소형화뿐만 아니라 각종 통신규격에 대한 대응(GSM/UMTS /LTE) 방안이 모색되고 있는 동시에, Wi-Fi·Bluetooth·GPS 등 복수의 통신기능 탑재가 보편화되고 있다. 이에 따라 하나의 단말로 대응할 수 있는 밴드 수나 기능이 증가하면서 RF 모듈 내의 부품 수도 늘어나는 양상을 보이고 있어, 기존의 메인 기판에 비해 고밀도 실장의 중요성은 더욱 커질 것으로 전망되고 있다.
하지만 스마트폰에서 메인 기판의 면적이 극도로 축소되는 모습이 관찰됨에 따라, 기존의 고밀도 실장기술로는 고성능화의 한계치에 도달한 것으로 보인다. 따라서 기능마다 최적화된 모듈화(Sip : System in Package)나 3차원적으로 회로를 구성하는 부품내장기판을 사용해, 전기특성의 향상과 모듈의 박형화에 따른 다양한 고성능화를 실현하는 방법이 제시, 적용되고 있다.
그러나 이들 부품내장기판에 사용되는 기판은 메인 기판과는 형태가 다르고(초박형 기판/세라믹 기판/캐비티 기판), 실장되는 칩 부품의 경우 초저배화가 진행되고 있기 때문에, 고밀도 실장뿐만 아니라 실장 후의 부품 신뢰성을 확보하기 위한 저하중 실장기술 개발이 요구되고 있다.
이 밖에도 스마트폰에서 관찰되는 다양한 제품 변형 형태(성능/가격/사이즈)에 대응하고 단기간의 제품개발을 실현하기 위해, 제품 사양에 맞춰 DSP (Digital Signal Processor)나 메모리 패키지를 SMT 실장 공정에서 쉽게 변경할 수 있는 PoP(Package on Packa-ge)에 대한 사용 움직임도 활발히 전개되고 있다.
실장기술에 대한 요구
여기서는 앞서 설명한 고성능화·다기능화·소형화·박형화가 한층 중요시되고 있는 모바일 인터넷 기기의 동향을 고려하여 특히 그 요구가 증가하고 있는 실장 프로세스 기술에 대해 설명한다.
1. 캐비티 기판에서의 인쇄
3차원 실장 중 하나인 캐비티 기판 실장에서는 접합재료인 땜납 페이스트의 공급을 위해 지금까지 주로 디스펜서가사용돼 왔다. 그러나 이 방법은 인쇄에 비해 덕트타임이 길어 생산에 상당한 시간이 소요되는 단점을 갖는다.
또한 장착하는 부품의 최적 인쇄형상이나 땜납의 양을 적절히 제어하기 위해서는 프린트 배선판의 패드 사이즈에 맞춘 디스펜서 노즐 직경의 변경이나 최적의 압력제어가 필요하기 때문에 생산성이 더욱 저하되는 문제점이 지적됐다.
하지만 이러한 문제를 해결하기 위해 메탈 마스크를 프린트 배선판의 캐비티 구조에 맞춰 볼록 형상으로 가공하는 동시에 인쇄기에 대해서는 땜납 페이스트를 가압하여 밀어내는 구조의 카트리지 헤드를 사용함으로써, 이전과 동일한 덕트타임으로 프린트 배선판의 패드 사이즈에 맞춘 땜납 페이스트 인쇄가 가능해졌다.
다음 부분에서는 여기에 사용되던 기존의 오픈 스퀴지 헤드와 새로운 카트리지 헤드의 충전력 차이에 대해 자세히 살펴보기로 하자. 먼저 오픈 스퀴드 헤드에서는 그림 2에서 관찰할 수 있는 것처럼 스퀴지가 개구부를 통과할 때(마스크상의 땜납 페이스트를 긁어낼 때) 땜납 페이스트의 충전력이 최대가 된다.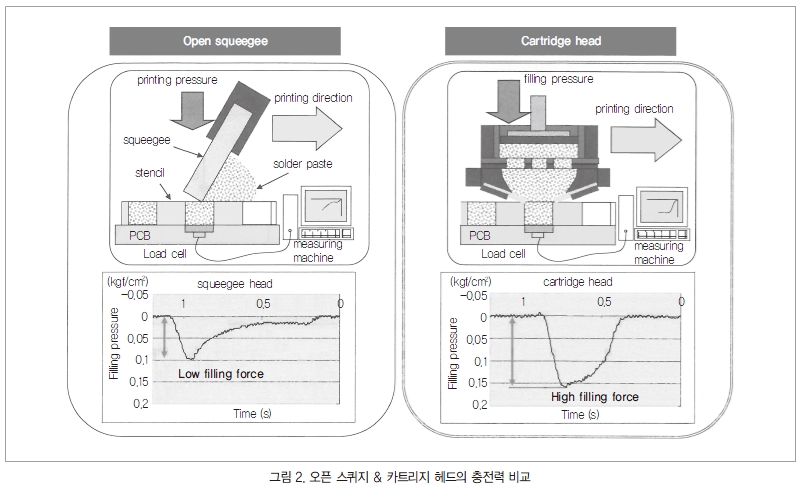
그러나 캐비티 인쇄에 이르면 이러한 땜납 페이스트를 긁어낼 수 없기 때문에 충전력을 캐비티 하부의 땜납 페이스트까지 확실하게 전달할 수가 없다. 그 결과, 충전력이 약해져 인쇄 전사량이 줄어들므로 인쇄 편차가 발생할 수 있다.
그러나 카트리지 헤드에서는 밀폐된 헤드 내에서 땜납 페이스트를 균일하게 가압하여 밀어내기 때문에 캐비티 바닥부의 땜납까지 충전압력이 전해져 전사량을 확보하는 동시에 안정된 인쇄를 실현할 수 있다.
2. 캐비티 기판에서의 CSP 실장
일반적으로 모바일 기기의 전자회로에서는 낙하 시 충격을 견딜 수 있을 정도의 접합강도가 요구된다. 하지만 현재 사용되는 것처럼 패키지의 피치가 좁아져 범프 직경이 작아지면 접합강도가 약해지기 때문에 이를 보강할 목적으로 언더필이 보편적으로 사용돼왔다.
언더필 보강에는 그림 3에 나타낸 것처럼 일반적으로 SMT 공정 후 세정·디스펜스·큐어 공정이 실행되는데, 이 공정은 통상적인 SMT 공법과 비교하면 설비나 재료에 상당한 비용과 시간이 필요하다. 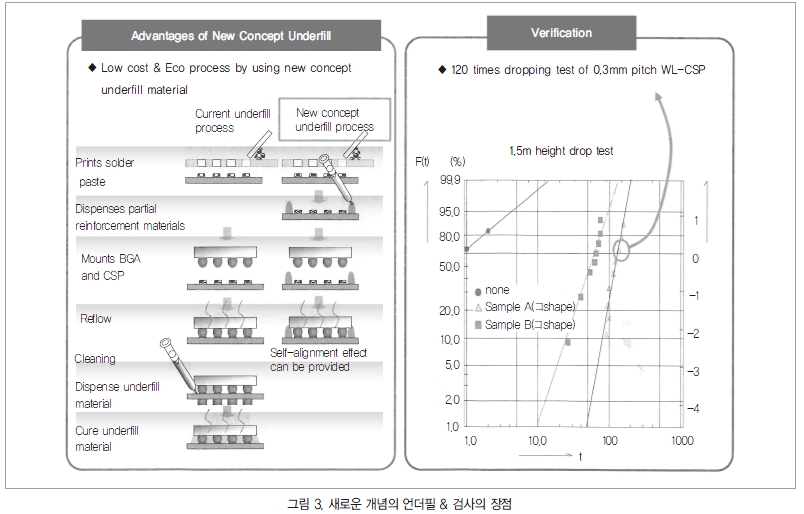
또한 캐비티 기판의 경우, 통상적으로 언더필 보강에 사용되는 것과는 달리 패키지와 캐비티 기판 사이의 간극이 좁은 것이 많아 언더필 공급에 문제가 있었다.
이 같은 문제로 인해 앞서 언급한 문제를 해결하는 동시에 도포 영역이 거의 없는 WL-CSP(Wafer Level CSP) 등에서도 접합품질과 낙하 내성을 보장할 수 있도록 새로운 개념의 언더필제가 제안됐다.
이 새로운 언더필제는 셀프 얼라인먼트성(Self-Alignment)을 특징으로 하므로, 이를 프린트 배선판의 패키지 바깥 둘레부에 도포한 다음 다른 부품과 동시에 패키지를 장착한 상태에서 리플로우 로(reflow furnace)를 통과시키면 땜납 접합과 보강을 동시에 완료할 수 있다.
이와 관련해 그림 3의 오른쪽 그래프는 0.3mm 피치 WL-CSP의 1.5 미터 낙하시험 결과를 예로 들어 그 와이블 곡선을 보여준다.
이것의 평균 고장횟수를 계산해보니 언더필을 사용하지 않았을 때에는 1회만에 파손됐지만 새로운 언더필제로 보강한 다음에는 낙하 내성이 대폭 증가했음을 알 수 있었다.
3. 소형·박형 부품 실장
그림 4는 0402 부품과 1005C(부품 내장용)의 정하중 파괴시험 결과를 보여준다. 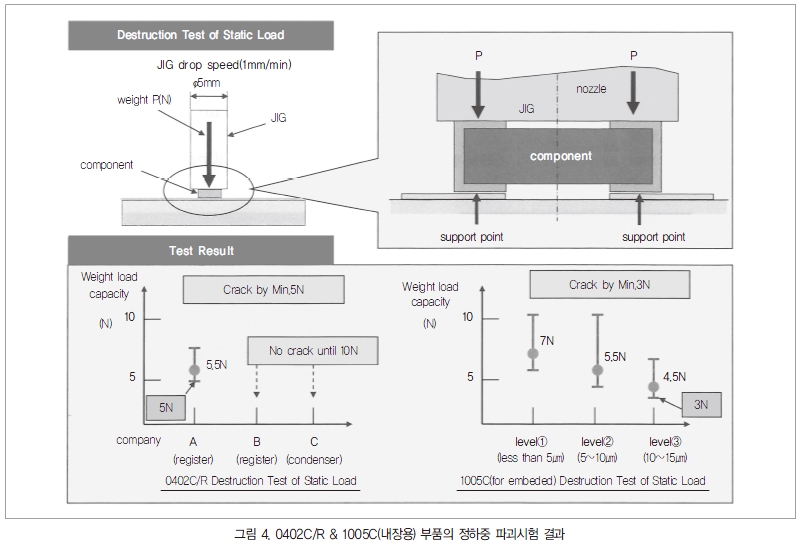
실험을 위해 0402 부품은 칩 저항 두 종류와 칩 콘덴서 한 종류를 사용하고, 1005C(부품 내장용)는 한 종류의 칩 콘덴서로서 외형은 1005 사이즈이지만 부품 두께는 0.15mm로 상당히 얇은 것을 사용했기 때문에 부품 휨을 세 가지 레벨(①5㎛ 이하, ②5∼10㎛, ③10∼15㎛)로 나누어 평가했다.
시험 결과, 0402 부품에서는 최소 하중 5N의 한 종류 칩 저항에서만 균열이 발생한 것으로 관찰됐다. 이에 비해 1005C(부품 내장용)에서는 휨 레벨 ③ 부품의 최소 하중 3N에서 균열이 발견됐다. 또한 각 휨 레벨별 결과는 레벨 ①은 7N, 레벨 ②는 5.5N, 레벨 ③은 4.5N(모두 평균값)으로 조사됐다.
특히 0402 부품과 같은 소형 부품은 실장 후 외관 검사, 리플로우 후 FCT (Function Test)에서는 부품의 파손 검사가 상당히 어려우며, 부품내장이 실행된 경우에는 프리프레그 적층 후 재작업(rework)이 불가능하기 때문에 칩 마운터는 부품이 파손되지 않는 범위 내에서 저하중으로 장착돼야 한다.
이를 고려해 최신 칩 마운터는 부품 흡착부의 질량을 최대한 가볍게 제작해 부품 장착하중을 저감시키는 동시에 부품 흡착부의 장착 높이·동작 편차를 억제할 수 있도록 동작을 제어함으로써 안정적인 장착을 가능케 하고 있다.
또한 0402 부품과 같은 초소형 부품에 대해서는 유량검출 타입의 고감도 검출센서를 사용한 ‘흡착 에러 검출’, 부품흡착부터 부품장착까지 이동 시 ‘칩 부품 낙하 검출’, ‘장착 에러 검출’, ‘노즐 막힘 검출’을 정밀하게 실시해 실장 신뢰성 향상을 위한 노력을 지속적으로 시도하고 있다.
이와 함께 부품이나 프린트 배선판의 편차를 보정하는 기능으로는 버티칼라인 카메라를 사용해 ‘흡착 발생·비뚤어진 흡착자세 검출’을 실시하는 동시에 정상적인 흡착 시에는 부품 두께를 측정하여 ‘장착 높이 보정’을 실현하고 있다. 이 경우 프린트 배선판의 휨과 관련해서는 높이 센서로 장착 높이를 보정해 부품을 장착할 수 있다.
4. 협인접 실장
0402 부품의 협인접 실장을 양산화하려면 다양한 편차를 보정하는 기술이 필요하다. 공정 내에서 관찰되는 주요 편차로는 프린트 배선판의 편차·메탈 마스크의 편차·땜납 페이스트 인쇄의 편차·전자부품의 편차·장착 편차 등을 꼽을 수 있는데, 이로 인해 발생하는 랜드·땜납 페이스트·부품의 위치 어긋남 현상은 0402 부품의 리플로우 후 품질에 상당히 큰 영향을 미치는 것으로 알려져 있다.
일반적으로 칩 마운터는 프린트 배선판의 마크를 인식하고 프린트 배선판의 이완과 수축을 측정한 다음, 기본적으로 랜드 위치를 기준으로 하여 부품 장착을 실행한다. 이 과정에서 앞서 언급한 편차에 의한 영향을 저감시키기 위해서는 각 공정에서 랜드, 인쇄 땜납의 위치, 형상과 더불어 부품의 흡착위치 등의 데이터를 지속적으로 측정하여, 여기서 얻어진 결과를 전후의 공정에 공급해 보정하는 방법이 효과적이다.
이를 위한 피드백 기능으로는 위치보정 기능과 자동 클리닝 기능이, 피드포워드 기능으로는 부품장착위치 보정기능과 불량 블록의 장착을 스킵(skip)하는 기능 등이 제공되고 있다.
5. PoP 실장
PoP 실장의 핵심 공법으로는 전사공법을 들 수 있다. 보통 이 공법을 이용해 바텀 패키지와 톱 패키지 간 접합을 실행할 때에는 톱 패키지 범프에 플럭스 등의 접합재를 도포한 후 바텀 패키지 위에 장착한 다음 리플로우가 실시된다.
이를 위해서는 처음에 바텀 패키지의 장착 위치를 인식한 후 트레이 또는 엠보스 테이프로 공급되는 톱 패키지를 노즐로 흡착한 다음, 칩 마운터 내에 설치된 전사 유닛을 통해 범프로 접합재료를 전사하고, 톱 패키지의 범프 인식 후 바텀 패키지 상에 장착을 실시해야 한다. PoP 실장과 관련해 제시되고 있는 과제들은 다음과 같다.
(1) 패키지 가열 시 휨
PoP용 패키지는 적층 시 전체 두께를 얇게 형성하기 위해 그 각각이 기존의 BGA보다 박형화된 형태로 제작되는데, 이로 인해 특히 바텀 패키지는 LSI 실장 부위와 톱 패키지의 접합 부위에서 열팽창률 계수의 차나 열응력 차이 등으로 인해 크게 변형되는 것으로 조사됐다.
예를 들면 그림 5와 같이 바텀 패키지에서는 상온 시 70㎛ 정도의 볼록 형상이, 그리고 리플로우 시에는 오목 형상으로 80㎛ 정도 휘는 현상이 관찰됐다.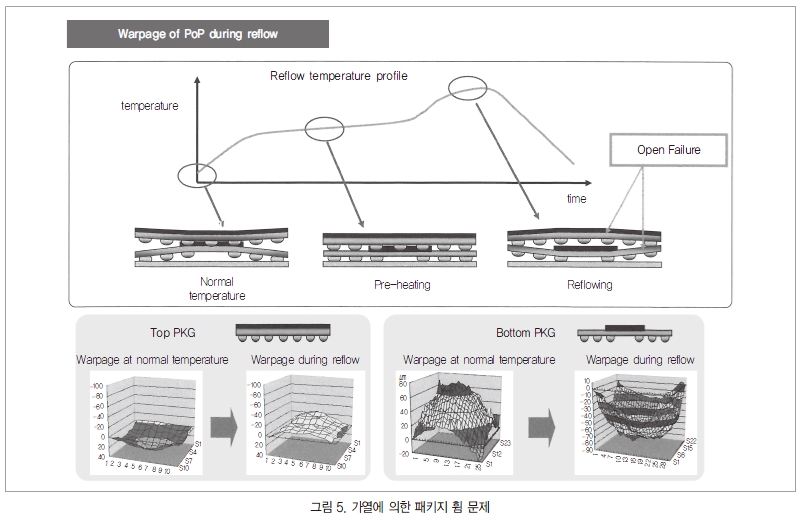
또한 톱 패키지에서는 바텀 패키지와는 반대로 상온 시 20㎛ 정도 휘고, 리플로우 시에는 20㎛ 정도의 볼록 형상을 형성하는 경우가 있는 것으로 확인됐다. 이러한 휨은 톱 패키지와 바텀 패키지 간 접합 불량과 바텀 패키지와 프린트 배선판 간 접합 불량이 발생하는 원인이 된다.
(2) 패키지와 초소형 부품의 혼합 실장
0402 부품과 같은 초소형 칩 부품과 패키지의 혼합 실장에서, 프린트 배선판에 인쇄되는 땜납 페이스트의 두께는 가장 얇은 부품을 기준으로 실시된다.
그러나 0402 부품을 기준으로 인쇄된 땜납 페이스트 상에 범프 직경이 큰 패키지를 장착할 경우, 앞서 설명한 것과 같은 패키지 가열 시의 휨이 발생하면 땜납 양이 부족해져 바텀 패키지와 프린트 배선판 간 접합 불량(오픈 불량)이 발생하는 원인이 된다.
(3) 패키지 범프와 인쇄 땜납의 위치 어긋남
일반적으로 BGA 실장에서는 땜납 페이스트 인쇄 위치의 어긋남과 패키지 장착 위치의 어긋남 현상이 복합적으로 작용해 접합 불량을 초래한다는 사실이 잘 알려져 있다. 이와 함께 패키지 가열 시 휨에 의해 땜납 페이스트와 범프의 접촉 부위가 떨어질 가능성을 고려한다면 위치 어긋남의 허용 범위는 더욱 까다로워질 수밖에 없다.
(4) 접합재료 전사 후 톱 패키지에서 범프 인식
바텀 패키지 상면의 정 위치에 톱 패키지를 제대로 장착하기 위해서는 범프 위치를 정확하게 파악할 필요가 있다. 또한 동시에 접합재료가 젖지 않고 전사되었는지를 검사하기 위해 장착 전 범프 인식을 실시해야 한다.
하지만 이때 사용된 접합재료가 일반적으로 적용되는 수지색 플럭스일 경우 범프 단일 화상과의 식별이 어려운 경우가 있어, 접합재료를 전사하지 않음으로써 실장 불량을 유발하는 경우가 있다.
이러한 문제를 해결하기 위해 땜납 부족과 가열 시 휨 과제에 대해서는 전사 유닛을 통해 패키지 범프에 필요한 양의 땜납 페이스트를 전사하여 땜납의 공급량을 늘리는 것이 하나의 해결 방안으로 제시되고 있다. 다만 각종 범프 높이의 패키지에 대응하기 위해서는 전사 유닛의 스퀴지 갭을 데이터로 변경하는 기능이 요구된다.
또한 인쇄 위치 어긋남과 가열 시 휨 과제에 대해서는 협인접 실장 부분에서 설명한 데이터 공급 시스템이 유효할 것으로 판단된다. 더불어 전사 후 검사에 관해서는 인식이 용이한 전용 접합재료를 사용하는 것이 원만한 과제 해결에 도움이 될 것으로 보인다.
결론
스마트폰으로 대표되는 모바일 인터넷 기기에서 고기능화·소형화·박형화를 한층 더 발전시키기 위해서는 실장회로의 공간 절약이 요구되므로, 이에 따라 메인 기판에서는 수동부품 내장, 플렉시블 기판에서는 초소형 부품의 실장비율이 높아질 것으로 예상되고 있다.
또한 상품이 범용화되기 위해서는 제품을 저비용으로 제조할 필요가 있어 프린트 배선판에서도 저비용 재료나 양산용 프린트 배선판의 사용이 증가할 것으로 예상되기 때문에 프린트 배선판의 위치 정밀도 편차를 보정할 수 있는 기술이 한층 중요시되고 있다.
더불어 통신기능을 담당하는 무선통신 모듈에서는 각종 통신 규격에 대응하는 동시에 복수 통신기능과의 혼재가 진행되고 있어 부품 수 증가에 반해 소형화·박형화를 실현해야 하므로, 머지않아 03015 부품이나 0201 부품이 사용될 가능성이 높아질 것으로 판단된다.
그리고 이러한 모듈부품을 장착하는 프린트 배선판에서는 수동부품을 위한 부품내장 기술과 능동부품을 위한 새로운 내장기술이 필요할 것으로 전망되므로, 이에 대응해 고품질·저비용으로 생산하기 위한 프린트 배선판 제조 기술과 더불어 땜납 페이스트 인쇄 기술·실장 시스템의 지속적인 개선이 필요할 것으로 보인다.
<문책(文責) : 酒見省二, 永冶利彦/
파나소닉 팩토리 솔루션즈>















































