모바일 PMU의 전력 MOSFET 장애 원인과
설계 예방법
오토모티브 시스템과 모바일 디바이스의 전력 MOSFET은 전력 장비와 트랜스미터에 의해 심각한 과도 전류와 혹독한 운영 환경에
노출될 수 있는데, 이 경우 유도성 스파이크와 같은 과도현상 이벤트로 인해 파괴적 EOS 상태가 발생할 수 있다.
그리고 이러한 상태가 발생할 경우 매우 단시간 내에 MOSFET 전력 스위치에 다량의 전류가 흐르는 원인이 되므로 주의가 필요하다.
이 글에서는 이러한 현상을 보다 자세히 살펴보기 위해 EOS의 원인과 이로 인한 디바이스 장애 및 이를 분석한 결과를 살펴본다.
자동차에서 구동되거나 충전이 이뤄지는 오토모티브 시스템과 모바일 디바이스의 전력 MOSFET은 전력 장비와 트랜스미터에 의해 심각한 과도 전류와 혹독한 운영 환경에 노출될 수 있다. 더욱이 회로 보드의 전도성 표면이 노출되고 대기 중에 부식성 오염물질이 존재할 경우, 낮은 임피던스 경로가 유도되기도 한다.
또한 이러한 환경이 조성되면 시간이 경과할수록 낮은 임피던스 경로와 오버로딩, 전자기식 커플링, 운영 환경에서 유발된 유도성 스파이크와 같은 과도현상 이벤트로 인해 파괴적 EOS 상태가 발생할 수 있다. 그리고 이러한 상태는 매우 단시간 내에 MOSFET 전력 스위치에 다량의 전류가 흐르는 원인이 된다.
따라서 이 글에서는 모바일과 오토모티브 애플리케이션용 외부 피드백 컴포넌트를 이용하는 고주파수 스위처와 레귤레이터에 대한 특별 설계 고려 사항과 장애 분석을 다뤘다.
이는 설계자들이 다양한 설계 메커니즘과 온칩 전력 스위치가 파괴될 수 있는 상황을 충분히 이해할 수 있도록 돕기 위함이다.
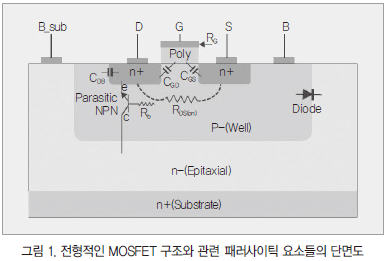
특히 이 중에서도 EOS 상태의 영향을 회피하고 제거하는 기술은 완제품과 PCB의 설계를 향상시키는 데 도움이 되므로 구체적으로 살펴보기로 한다.
또한 이 글에서는 랩 테스트 실행을 위한 팁을 제시하고, 고밀도/초소형 모바일 설계1), 2)에서 발생 가능한 문제들을 방지하는 엔지니어링 지침을 제안한다.
사례 연구
2011년 한 설계자는 실내 테스트를 실행하는 동안, TI의 LM26484 PMU 스텝 다운 DC/DC 컨버터 NMOS 스위치에서 쇼트가 발생했다고 보고했다. 이 레귤레이터는 새로운 인스트루먼트 패널(instrumentation panel)을 이용해 설계된 것으로, 벅 컨버터에서 전원을 공급받는 LED의 뱅크가 경부하 상태에서 작동하도록 고안된 것이었다.
이러한 문제가 제기되자 TI는 이를 해결하기 위해 설계자들에게 6V 이상의 과도전류가 흐르는지 클록 주변의 공급 핀 전압을 모니터링해 줄 것을 요청했다.
그 결과 그들은 과도현상 스파크가 8V 이상에서 수백 나노초 동안 최대에 달하며, 더욱이 이 같은 상황이 빈번하게 발생한다는 사실을 확인했다. 더불어 이때 공급 핀에 대한 디바이스의 절대 최대 한도는 VIN=6V로 측정됐다.
그리고 p-(well) 베이스가 전력 디바이스의 전형적인 EOS 시나리오인 n+ (S)에서 에미터에 바이어스를 걸 때, 패러사이틱 NPN[그림 1에 제시된 바와 같이 n+(S), p-(well), n+(D)로 구성]이 하드를 작동시키는 것으로 의심됐다. 그림 2는 이와 관련해 패러사이틱 컴포넌트들이 존재하는 MOSFET의 등가 회로 모델을 보여준다.
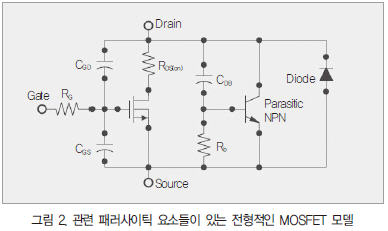
이와 함께 PCB의 레이아웃(그림 3)을 조사하자 전원핀의 상단 트레이스가 전원 플레인과 1회 접속됐고, 이들의 긴 트랙이 우회 커패시터를 무력화시키는 것으로 드러났다. 이에 따라 이러한 상황이 다시 발생하지 않도록 TI는 개선된 설계 지침을 제시했다.
이 지침을 실현하려면 VIN과 접지 플레인 사이에 적절한 대형 벅 커패시터를 추가하고, 로컬 바이패스는 주파수 대역이 보다 넓은 추가적인 커패시터들로 증강되도록 구성해야 한다. 그림 4에 구현된 이러한 예방 조치들을 통해 대규모 과도현상으로 인해 PMU의 통합 회로에 응력이 가해지는 것을 방지할 수 있음을 확인할 수 있었다.
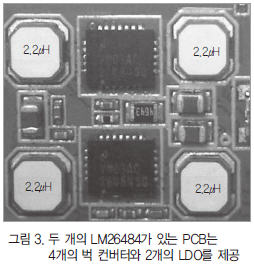
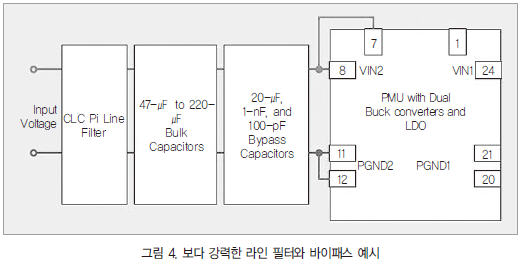
더불어 EOS를 제거할 수 있는 보다 복잡한 솔루션으로 그림 5에 나타낸 것처럼 전원핀과 접지핀 가까이에 우회 커패시터들을 배치하는 방법이 제시됐다. 이 경우 전원 접지 트랙이 확장되고, 보다 큰 바이어스의 이용이 자유롭다는 점에 주목할 필요가 있다. 이 같은 특징으로 인해 이 권고안은 고객들에게 보다 유용한 솔루션으로 평가받았다.
한편 2012년에는 또 다른 고객이 듀얼 벅 컨버터와 듀얼 LDO가 존재하는 동일한 제품군의 다른 PMU로 인해 일부 장애를 겪었다고 보고했다. 특히 이 경우에는 시스템이 출하되고 얼마 안 있어 벅 컨버터 스위치에서 쇼트 발생 및 개방 현상이 나타난 것으로 조사됐다. 이를 자세히 검토한 결과, 여기에 사용된 PMU는 오토모티브 애플리케이션에서 스텝 다운 전원 공급 장치로부터 전원을 공급받는 것으로 확인됐다.
이러한 가운데 2014년부터는 다수의 인포테인먼트와 안전 시스템이 자동차의 표준 장치로 사용되고 PMU의 생산 속도는 약 10배 정도 증가하며, 이로 인해 연관된 모든 관계자들은 상당한 이익을 얻을 것으로 기대되고 있다.
이에 대응하기 위해 실시된 디바이스에 대한 고객들의 엄격한 테스트와 보드 레벨 스트레스 측정에서는 눈에 띄는 이상 현상은 발견되지 않았지만, 다소 흔치 않은 장애가 발생한 것으로 관찰됐다. 하지만 이상 입력 전압 과도현상을 유발해 디바이스를 손상시킬 수 있는 차량용 애플리케이션과 관련된 다수의 메커니즘은 이미 잘 알려져 있으며 이를 위한 개선 가능한 기회들도 많이 제공되고 있는 편이다.
일반적인 EOS의 원인
PMU에서 대부분의 EOS 상태는 부적합한 설계 사항이나 일부 시스템에서 미묘한 패러사이틱 소자들을 간과하는 데에서 발생하고 있다. 특히 이러한 현상은 산업용/오토모티브 애플리케이션에서 두드러지게 관찰된다.
하지만 이로 인해 중요한 전기기계적 레이아웃 차이나 이례적인 주변 환경의 신뢰도 문제가 발생할 수 있다. 또한 EOS는 제조공정, 테스트, 컴포넌트 노화와도 연관이 있는 것으로 나타났다.
이에 따라 다음 부분에서는 가장 일반적인 EOS 원인을 살펴본다. 더불어 설계자들이 EOS 문제를 제거하는데 도움이 되는 적합한 설계 팁과 권고안도 검토할 계획이다.
한편 이 과정에 필요한 장애 메커니즘을 규명하는 일반적인 방법으로는 문서화된 자료를 검토하는 방법이 주로 실행되고 있다. 여기서 더 나아가 보다 많은 정보를 원하는 독자들은 고장 형태 및 영향 분석(FMMEA)을 통해 장애의 물리적 특성을 연구할 것을 강력하게 권장한다.
오토모티브 애플리케이션에서
배터리와 배선에 의해 발생하는 EOS
낮은 온도에서 크랭크 작동 시 차량의 12V 배터리 전압이 너무 낮게 저하되면, UVLO(undervoltage lockout)가 보호를 실현하기 전 온 보드 PMU의 컨트롤, 타이밍, 결정 회로가 오작동을 일으킬 수 있다. 그리고 이로 인해 슛스루(shoot-through)와 클램핑 해제와 같은 바람직하지 못한 결과가 MOS 스위치에 스트레스를 가하고, 시간이 경과하면서 영구적인 손상을 일으킬 수 있다.
이와 함께 순간적으로 디바이스 손상을 유발하는 또 다른 원인으로는 높은 전압의 엣지율이 빠른 과도현상을 꼽을 수 있다. 더불어 또 다른 사례인 로드 덤핑은 12V 배터리를 발전기에 연결 시, 순간적으로 제거될 때 발생하는 것으로 조사됐다. 이 경우 긴 배선에 의한 유발효과로 인해 로드는 100V 이상에서 갑작스레 증가할 수 있으며, 이러한 현상은 정상 수준으로 감소되기 전까지 수백 밀리초 동안 지속되는 것으로 나타났다.
특히 빠른 과도현상이 발생하는 경우의 고전압 스파이크는 터미널 정전용량을 통해 MOSFET의 드레인 터미널에서 게이트까지 전파될 수 있다. 이는 게이트에 빠른 속도로 바이어스를 걸어 런어웨이 상태가 발생할 가능성을 증가시킨다. 하지만 이때 관찰되는 권장된 최대 운전 공급 전압이 약간 초과되는 현상은 파괴적인 이벤트는 아니다.
그러나 공급 전압이 최대 수준을 초과하고 충분한 에너지가 유지된다면, 몇 나노초 이내에 디바이스가 합선되거나 애벌런치 항복(avalanche breakdown)이 유발될 수 있다. 게다가 배터리 케이블 연결이 소실되거나 안전하게 보호되지 못한 경우, 강력하고 갑작스러운 기계적 진동이 발생할 수 있으며 이로 인해 유사한 고전압 과도현상이 나타날 수 있다.
부적합하고 빈약한 전원 공급 파이패스
전원 공급 파이패스가 불충분하면 이상 작동이 발생해, 타이밍 이슈에서 슛스루 스트레스가 초래될 수 있다. 따라서 적합한 우회 커패시터는 반드시 피크 전압 과도현상을 충분히 커버할 수 있는 정격전압을 포함하고 있어야 한다.
이때 트레이스에서의 누출과 패러사이틱 인덕턴스는 스위처의 펄스 터미널에서 생성되는 가장 크고 심각한 L(di/dt) 과응력 펄스를 일으키는 원인이 된다. 그리고 앞서 설명한 바와 같이 이러한 높은 에너지 펄스가 발생할 경우, 디바이스 고장을 일으킬 수 있다.
따라서 적합한 조치를 취해 바람직하지 못한 유발 경로를 제거하는 것이 무엇보다 중요하다. 이를 위해서는 우선 우회 커패시터가 가능한 디바이스 레일 핀 가까이에 배치되도록 해야 한다. 또한 과도현상이 많이 관찰되는 모든 경로에 가능한 많은 두꺼운 금속 트레이스를 이용해 패러사이틱 인덕턴스를 감소시키도록 한다. 그리고 마지막으로 과도현상 차단 요소나 유사한 기술을 이용해 잠재적으로 파괴적인 고전압 스파이크를 약화시키도록 한다.
과부하나 결함있는 로드
커패시터로 인해 쇼트된 출력
스위처의 출력 전류(IOUT 로드)가 정격 한도를 초과하면, 일반적으로 내장되어 있는 보호 회로가 디바이스에 대한 즉각적인 손상을 막아준다. 그러나 이러한 과전류 이벤트가 자주 발생하면 EOS 조건이 누적되어 시간이 경과하면서 디바이스에 영구적인 손상을 초래할 수 있다.
일반적으로 이러한 손상은 보호 회로가 작동하기 전에 필요한 마이크로초 범위에 있는 유한 지연시간과 관련이 있다. 반면 단락 부하를 제외한 출력 커패시터에 결함이 있으면 낮은 임피던스 경로에 영향을 미쳐 최대 부하와 함께 동적 단락 회로 전류가 발생하게 되므로, 또 다른 지속적인 EOC 상태가 발생할 수 있다.
동기 스위치로 인한 일시적인 과전류 동작
통상적으로 MOSFET 바디 다이오드는 MOSFET 스위치 자체에 비해 역회복 시간이 길다. 게다가 보조 다이어드가 켜졌을 때 MOSFET의 바디 다이오드가 여전히 작동한다면, 슛스루와 유사한 단락 회로 상태를 유발할 수 있다.
연구 결과 이러한 현상은 디바이스 설계에 의한 패러사이틱 소자 및 회로의 타이밍 이슈로 인해 발생하는 것으로 조사됐다(그림 1과 2 참조).
더욱이 특정 조건에서는 내부 패러사이틱 인덕턴스와 정전용량이 에너지를 저장할 수 있으므로 하나는 꺼지고 하나는 켜지는 것처럼 추가적인 전류가 FET 스위치의 바디 다이오드를 통해 환류될 수 있다. 이는 고속 스위칭과 함께 패러사이틱 정전용량 메커니즘 C(dv/dt)에 의한 것으로, 부하 조건에 상관없이 높은 피크의 전류 과도현상을 지속시킨다.
게다가 이러한 유형의 EOS는 앞서 설명한 바와 같이, 전력 레일 무결성 이슈와 결합될 경우 급격히 증대된다.
이에 대응해 파워 트레인 회로의 시뮬레이션과 보다 정확한 설계 및 MOSFET의 소스와 드레인 사이에 있는 쇼트키 다이오드의 보호용 디바이스를 늘리면 상황을 개선시키거나 제거할 수 있다. 특히 쇼트키 다이오드를 이용하면 바디 다이오드가 환류 전류에 의해 켜지지 않는 것으로 입증됐다. 패러사이틱 pn 접합을 작동시키고, 잡음을 발생시킬 수 있는 접지 이하의 초과 언더슈팅을 실시하는 것 또한 쇼트키 다이오드로 스위처의 효율성을 적당히 증대시키는 혜택을 제공하는 것으로 나타났다.
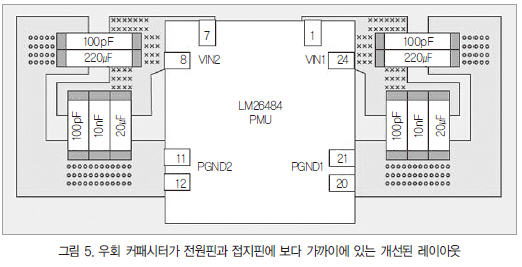
디바이스 장애 검증 및 분석
장애 분석(FA)은 육안 검사, 임피던스 측정, X-레이, SAT. Sam, 배출 핫스팟 OBIRCH 분석, SEM, SCM 툴, 기술 등을 이용해 디바이스 장애의 장애모드 메커니즘과 근본적인 원인을 규명하는 데 사용된다. 또한 장애 분석은 고객의 설계나 제조공정에서 일반적으로 간과되는 요소가 원인이 될 가능성도 조사한다.
이를 통해 원인으로 확인되면, TI는 장애 재발을 방지하는데 도움이 될 수 있도록 내부 및 외부 고객들에게 관련 권고안과 억제 조치를 제공한다.
장애 모드 메커니즘
1. 정전기 방전(ESD) 파괴 또는 게이트 서지
디바이스 접합이나 산화물의 파열 손상은 디바이스와 시스템의 테스트 및 어셈블리 동안 부적절한 처리로 발생할 수 있다.
게다가 이러한 메커니즘은 디바이스의 정전기 방전을 유발하고, 스위치 회로에 도달하는 외부 고전압 서지 이벤트를 발생시키기도 한다. 구체적으로 이로써 관찰되는 휴대폰이나 태블릿의 통신 포트 커넥터와 손가락 사이의 ESD 이벤트는 시스템을 영구적으로 손상시키는 것으로 조사됐다.
이에 대한 대응은 프로세스 기술 노드가 지속적으로 작아지고 있으므로, 디바이스 차원의 ESD 보호는 시스템 차원만으로는 불충분하다. 반면 트랜소브(transorb)나 TI의 TPD1E10B06 보호 다이오드와 같은 과도 전압 억제기는 우수한 교정 수단으로 적용되고 있다.
2. 마모 및 훼손 메커니즘
쪾다이 균열은 일반적으로 극단적인 온도 사이클에서 발생한다.
쪾시간이 경과하면, 고전압 스트레스로 절연 파괴가 유발돼 게이트 산화물 쇼트 회로가 초래 된다.
쪾전류 과부하 등으로 인한 EOS로 인해 와이어 본드와 금속 루트가 개방될 수 있다.
쪾전원 공급 라인의 과도 전압이 다이에 위치한 수동 디바이스와 능동 디바이스를 손상시킬 수 있다.
3. PCB 요소와 환경
쪾습도나 오염물질에 의한 영향 및 필라멘트가 전도성을 띨 경우 회로 장애가 발생할 수 있다.
쪾쇼크, 진동, 재료의 피로 등으로 인해 다이 파단이 발생할 수 있다.
쪾유리 전이 장애로 알려진 폴리머 강도 소실은 고온 응력 하에서 발생할 수 있다.
쪾우회 커패시터와 로드 커패시터가 누설되거나 쇼트될 수 있다.
쪾고온 스트레스나 기계적 진동으로 인해 절연이 마모되고 훼손되어 인덕터 권선이 쇼트 회로가 될 수 있다.
4. 컴포넌트 노화 및 부적합
처음에는 데이터시트 내역에 부합될지라도 컨포넌트가 노화되면 MOSFET 장애의 원인이 될 수 있기 때문에1), 제조 부서와 제품 엔지니어링 부서에서는 데이터 시트 한도보다 약간 높은 정격에서 부품을 번인(burn-in)하고 테스트할 것을 권고하고 있다.
이는 고유한 웨어퍼 결함 밀도와 임의의 프로세스 관련 문제들이 발생할 수 있는 한계 디바이스들을 제거할 수 있도록 도와준다. 따라서 이를 올바르게 실행하여 나중에 유용한 리소스를 낭비하고 현장 고장에 대해 책임을 지는 것보다 생산 수율을 감소시키는 것이 바람직할 것으로 판단된다.
장애 분석 결과
앞서 언급한 2012년의 사례 연구에서는 스위치의 드레인과 소스 채널이 오토모티브 애플리케이션에 통합돼 있어, 고객들이 PMU IC, 회로 보드나 서브 시스템의 신뢰도에 문제가 있는지 확인할 수가 없었다. 따라서 이들 각각에 대한 엄격한 테스트가 실시됐는데, 특히 명세 한도 이상에서 스트레스를 가하고 그 결과를 분석하는 과정이 실행됐다.
그 결과 표면으로 드러난 장애는 확인할 수 없었다. 때문에 레이아웃, 전기 배관, 시스템 설치 및 콜드 크랭킹, 약한 배터리 또는 때때로 끊기는 긴 전원 케이블 연결/전원 케이블 소실과 같은 부적합한 운전 상태가 장애의 주된 원인으로 꼽혔다.
이 과정에서 고객과 각 하청업체들은 자신들의 실험실에서 최초의 장애를 재현할 수 없었기 때문에, TI로부터 확인을 받아야 했고 지원을 요청해야 했다. 이에 대한 실내 장애 분석 결과 사례는 그림 6과 그림 7에서 확인할 수 있다.
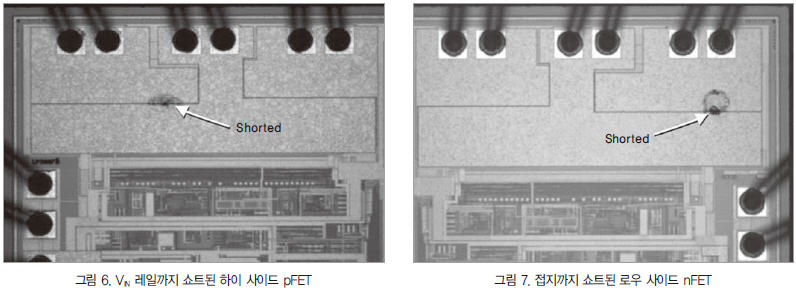
이를 분석한 결과, 디프로세스된 다이에서 관찰된 탄 자국이 EOS 상태로 인해 생성됐을 가능성이 시사됐다. 이러한 가정을 검증하기 위해 ① 5V 작동과 ② 시동 조건으로 설정된 실험 환경에서 장애가 유발될 수 있는지를 검토했다.
실험에는 진폭, 주파수, 온/오프 타임을 프로그래밍할 수 있는 다용도 전원 공급 장치인 키슬리 2420 3A 소스 미터를 이용해 VIN을 5V으로 프로그래밍하고, 100ms 간격으로 반복되는 50ms 펄스를 주입했다. 그리고 200Ma 이상으로 로딩하자, 이상 전류가 관찰될 때까지 펄스 진폭이 5분 간격마다 0.5V 증분으로 증가하는 것을 확인할 수 있었다.
다음에는 EOS를 육안으로 확인하기 위해 부품을 디캐핑(decapping)했다. 그 결과 피크-투-피크(peak-to-peak) 펄스 전압이 약 7.5V에 도달하자 스위치에서 쇼트가 발생하는 것으로 조사됐다. 이를 토대로 펄스가 9V로 증가했을 경우, ESD 구조에서도 손상이 발생할 것으로 추정됐다.
시동 동안 스위치의 단락을 재현하는 것은 한층 어려웠다. 그러나 벤치 전원 공급 주기로 벅 컨버터를 켜고 끄자, VIN은 비교적 천천히 부드럽게 시동 과도현상을 나타냈고, 약 6ms에서 안정화되었다(그림 8). 그리고 전원 공급을 7V보다 약간 높게 설정한 경우에도 스위처 스트레스 테스트를 실시하는 며칠 동안 장애가 발생하지 않았다.
더불어 차량 조건에서의 동작을 보다 면밀하게 구현하기 위해 전원 공급 장치와 디바이스 사이의 케이블 길이를 약 30cm에서 약 1.5m로 연장시켰다. 그 결과 일반적으로 루트가 12V인 배터리에서 디바이스까지인 3개의 긴 와이어에서 보다 많은 인덕턴스가 발생하는 것으로 관찰됐다.
또한 이와 함께 전원 공급 장치의 소프트 전원 공급 주기를, 기계적 바운스와 채터가 기계적 릴레이 접촉에 의해 유발되는 과도현상처럼 거동하는 기계적 토글 스위치로 교체했다(그림 9).
이 외에도 전원 공급 출력을 0.5V로 설정해 테스트를 실시한 다음, 토글 스위치를 20회 플리-플롭(flip-flopped)시켰다. 이때 과전류 장애가 검출되지 않는 경우에는 공급 전압을 0.2V로 증가시키고, 스위치를 다시 20차례 토클 온/오프시켰다. 그리고 부품에 장애가 발생할 때까지 이러한 과정을 반복적으로 실시했다.
그 결과는 대단히 성공적이었다. 예를 들면 벅 컨버터의 하이 사이드 또는 로우 사이드 스위치는 약 7.5V VDC에서 전원 공급 출력으로 쇼트되었다. 또한 VIN핀은 보다 빠른 턴온 과도현상을 나타내는 10pF 프로브로 모니터링됐으며, 20㎲에서 11V 이상의 오버슈트가 발생하는 것으로 나타났다. 그리고 실제 L(di/dt)의 로트(lot)는 보다 높게 측정됐고, 반복이 가능한 파괴적인 EOS 상태가 발생한 것으로 확인됐다.
고객들은 이러한 벤치 설정을 통해 현장에서와 동일한 장애를 재현했다는 사실에 크게 만족했다.
결론
이 글에서는 통합 전원 관리와 전압 레귤레이터 회로에서 MOSFET 트랜지스터와 관련된 일반적인 디바이스 장애 메커니즘을 다뤘다. 또한 EOS 문제를 완화하고 제거하는데 도움이 되는 일반적인 예방책과 특정 PCB 레이아웃 기술, 컴포넌트 선정 팁을 제시했다.
참 고 문 헌
1) Kern Wong. (2012, April 27). PCB and ESR subtleties in switching regulator and LDO designs. EDN [온라인]. 에서 이용 가능
2) Kern Wong. (2012, June 21). High-performance load and line-transient test jigs for mobile regulators. EDN [Online]. 에서 이용 가능
3) Power MOS FET application note, Rev.2.00, Renesas Electronics, REJ05G0001, Aug. 23, 2004 [온라인]. 에서 이용 가능 (use Search, Advanced Search, Document Search to find REJ05G0001)
4) Analysis of MOSFET failure modes in LLC resonant converter, Fairchild Semiconductor, AN-9067, Nov. 5, 2009[온라인]. AN-9067.pdf에서 이용 가능
Kern Wong 텍사스 인스트루먼트















































