Build-Up 기술의 이해
장동규 마이크로조이닝협회
BUILD-UP PCB : 의미
· Build는 Building의 Build로 ‘세우다, 구축하다’의 의미이다.
· Up은 Up, Down의 Up으로 ‘위를 향하여’를 의미한다.
· Build-Up은 두단어를 조합하여 ‘순차적으로 쌓아 올라감’의 의미를 갖는다.
· 도금, Print 등에 의해 차례로 도체층 절연층을 쌓아 올리는 다층 인쇄 기판의 제조법이다.
· 유럽, 미국, 아시아에서는 HDI라고도 불리운다.
· HDI : 고밀도 상호접속, High Density Interconnection
· IC나 Hybrid IC의 제조에서는 예전부터 Build-Up 공법을 사용했다.
· 대형 컴퓨터용 세라믹 고다층판 → Polyimide 막으로 형성된 Build-Up 층이다.
· 90년대 이후 급성장 → 유기재료를 이용한 Build-Up 다층기판
· 1967년 → Build-Up 공정 아이디어 창출
· 1990년 → 양산시작
BUILD-UP PCB : 출현
최근 전자 전기 산업은 전자기기의 소형화, 박형화를 위해 부품 실장시 고밀도화, 고정도화, 고집적화가 가능한 다층 인쇄회로기판을 이용한 실장 기술을 채용하고 있는 추세이다. 더불어 최근 이동통신기기와 디지털 가전 시장을 중심으로 소형화, 박형화가 급격히 진행되면서 다층 인쇄 회로 기판에 대한 수요가 급증하고 있다. 이는 전자제품에 대한 소비자 요구는 좀 더 작고 빠르고 휴대하기 간편한 것에 기인하는 것이다.
특히 uBGA, tcp, csp, mcm 기술 발달에 의해 이러한 칩을 실장할 수 있는 고밀도 인쇄 회로 기판에 대한 관심이 증가하고 많은 투자와 연구가 진행 중이다. 층간의 전기적 접속을 담당하는 Via의 제조 공정에 따라 Photo Via, Laser Via, Plasma Via로 구분할 수 있는데 일부 공정에서 스크린 인쇄법을 도입해 기존의 도금, 에칭 등의 습식 공정에서 가공액들의 소모를 줄여 환경 친화적인 건식 공법으로 옮아가는 실정이다.
일반적으로 PCB를 한층 한층씩 쌓아 올려 다층을 형성하는 개념의 Process로 빌드업은 한층 씩 제조하고, 품질을 평가함으로써 전체적인 MLB 수율을 높일 수 있고 필요한 Layer끼리 연결이 가능해서 일반 PCB에 비해 보다 고밀도, 박판화에 유리하다. 따라서 주로 핸드폰, 캠코더, 노트북, PDA에 사용되며 최근 첨단 네트워크 장비와 블루투스 제품에도 적용되고 있다. Build-Up은 우선 다층기판상에 절연층을 형성하고 Laser로 미세 hole을 가공해 동도금에 의한 도체층과 via hole을 만든다. 도금에 의한 얇은 도체층이므로 보다 미세한 회로 패턴이 가능하고(100㎛ 이하), 150㎛ 이하의 미세 via hole을 실현한다. 현대에는 특히, via-on-via에 의한 배선 자유도가 향상되고, MCM 용도에서 SVH의 고밀도화 대응까지 다양한 변형이 용이하다(표 1).
BUILD-UP PCB란?
· Build-Up 공법은 도체층, 절연층을 한 층씩 형성하여 도체 층을 쌓아가는 방식이다. 많은 경우 양면 기판에 차례로 적층을 하며 층간마다 필요한 Via 층을 구성할 수 있어 고속의 신호대응이 가능해 현대의 고밀도 고집적 기기 적용에 유리하다.
· Micro Via를 구성하는 방법으로는 주로 RCC를 사용한 절연층을 CO₂Laser drill을 이용하는 기술이 약 70%를 차지하고 있으나, 3mil 이하의 Via 구성에는 한계점이 있는 바, 향후의 주종으로는 UV laser를 이용한 가공 기술과 laser drilll 및 laser hole 속 신뢰성이 중요한 도금 기술이 필요없는 범프 형성 기술이 Build-Up을 선도할 것으로 보인다.
· Build-Up 공법은 향후 거의 모든 PCB에 복합적으로 적용이 가능한 기술로써 Fine pitch BGA 등 SMT 기술과 발맞춰 경박 단소화를 주도할 매우 중요한 기술임에 틀림없다.
· Build-Up 제품은 기존의 PCB 제조방법과는 달리 내층을 기준으로 양면으로 차례로 층을 쌓아 올리는 방법이다. 이 방법에는 BVH HOLE 형성방법에 따라 크게 두 가지로 나뉘어 지는데, 전자는 Laser로 Hole을 가공하는 방법이며, 후자는 인쇄, 노광에 의해 Hole을 형성하는 방법이다. 또한 층간 절연재료에 따라 RCC(Resin Coated Copper foil)와 액상 절연재료로 열 경화성 절연수지와 감광성 절연수지로 나뉜다. 이러한 원재료를 이용하여 층을 계속해서 쌓아 나가는 공법이 Build-Up 공법이며, 일반적으로 RCC, Prepreg를 이용해 Laser(CO₂Laser)로 Hole을 가공하는 방식을 채택, 생산하고 있다.
일반 MLB와 Build-Up PCB의 차이점
1. 원자재
원자재에 있어서 일반 MLB와 Build-Up PCB의 차이점은 다음과 같다(표 2).
· RCC(그림 1)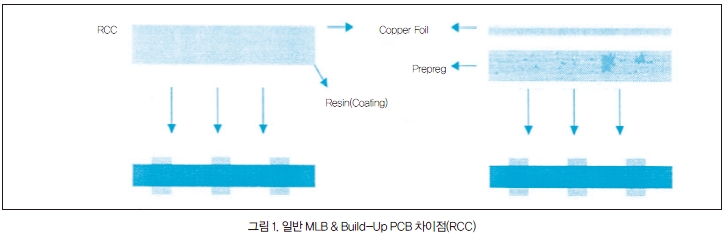
· 유전율 : 외부의 전기적 신호에 대한 부도체 내의 분자들의 분극현상 정도를 말하며, 값이 작을수록 절연성이 좋은 것이다(RCC는 Layer 간 두께를 줄일 수 있다).
2. 주요 공정
공정은 Plugging 인쇄, Conformal, Laser-Drill의 3가지 공정으로 나누어 설명하려 한다.
2.1 Plugging 인쇄 공정
Plugging 인쇄 공정은 RCC 적층 후 두께 편차를 최소화하기 위해 내층의 Buried Via Hole을 Ink로 충진시켜주는 공정이다(그림 2).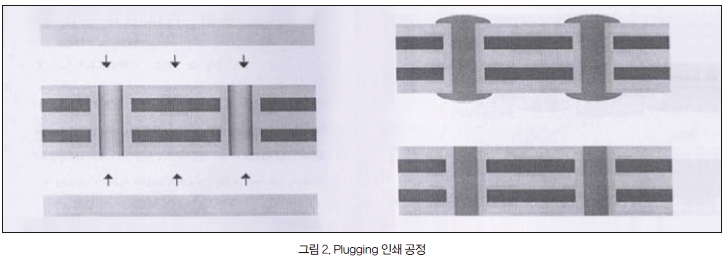
이 공정의 주요 파라미터는 다음과 같다.
· 인쇄기
· NK : PHP 900 IR-6(Hole 속 매꿈 Ink)
· Squeeze : 전용 Squeeze(45°) 사용
· 인쇄 후 자연 방치 시간 : 20분
· 건조 환경 : 150℃ 30분
· Belt-Sanding : 2회 실시
· Plugging 인쇄 공정의 순서는 정면→JIG &PNL SETTING →PLUGGING 인쇄→자연방치(20분)→건조(150℃, 30분)→ BELT-SANDING 2회→검사 순으로 이뤄진다(그림 3). 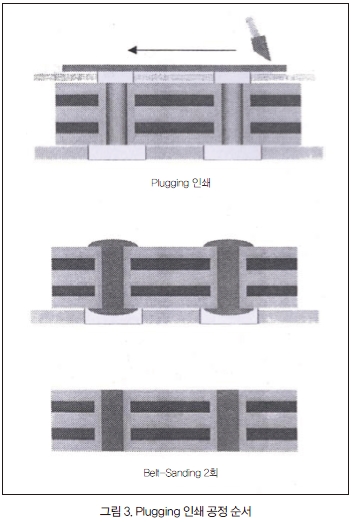
2.2 Conformal 공정
이 공정은 CO₂Laser 가공 전 해당 부위의 동박 부분을 제거시켜주는 회로 형성 공정이다(그림 4, 그림 5). 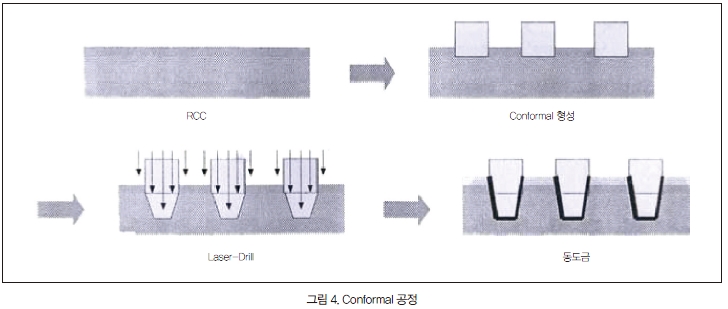
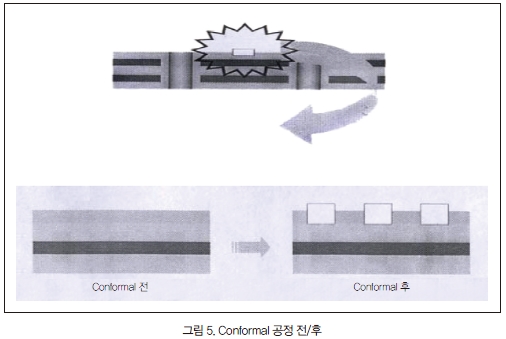
Conformal 작업 파라미터는 다음과 같다.
· 필름 제작시 Hole size : 110㎛
· 에칭 후 Hole size : 140±10㎛
· Build-Up 전용 D/F(25㎛) 사용
· 자동 노광기(4점 방식) 사용 : 노광량 - 50mj/㎠
· AOI - 전용 검사 장비
2.3 Laser-Drill 공정
Laser-Drill 공정은 YAG Laser와 CO₂Laser로 나뉜다.
우선 YAG laser는 U.V(자외선) 광선을 이용해 동박과 레진을 가공한다(Conformal 공정 없다). 하지만 생산성이 낮다는 단점이 있다.
CO₂Laser는 I.R(적외선) 광선을 이용해 레진을 가공한다(Confor-mal 공정 있다). 생산성이 높다는 장점이 있다. 이에 대한 설명을 그림 6에 나타냈다.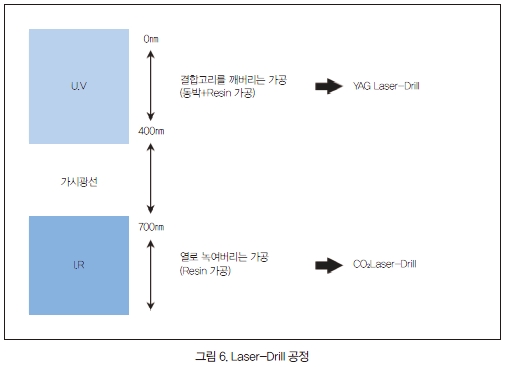
· Stack Via 가공(그림 7)
· Hole 속(그림 8, 표 3)

결론
다층판 제조 프로세스에서는 구성하는 각 층을 일괄적으로 적층해 관통 Via에 의해 층간 접속을 하지만, Build-Up 법에서는 도체층, 절연층을 1층씩 쌓아올려 blind via, buried via에 의해 층간 접속을 한다.
Build-Up 다층 기판은 이러한 프로세스를 가지고 있으므로 높은 배선 밀도를 실현할 수 있지만 한편으로는 공정이 복잡해 제조 리드타임이 길어질 수 있다.
제조 비용은 기존의 다층 기판에 비해 수 배가 넘는다고 하여 가격 절감이 큰 과제로 남아있다. 가격 절감의 수단 중 하나로 또는 더욱 고밀도화를 실현할 목적으로 일괄적층법의 개발이 도처에서 진행되고 있다. 또한 세라믹 다층기판은 오래전부터 일괄적층법으로 제조되고 있다. 다음호에서는 A~D 타입으로 나누어 설명하고, 각 타입별 작업표준, 프로세스 및 체크포인트에 대해 알아본다.
















































